

東北大学と東京エレクトロンの共同研究による成果、次世代デバイスMRAM実用化に道
東北大学・原子分子材料科学高等研究機構(AIMR)および流体科学研究所(IFS)の寒川誠二教授の研究グループは、次世代のデバイスといわれるMRAM*1の実用化に道を拓く技術として、酸化と金属錯体反応*2を同時に実現する装置を開発することで、これまで困難であった遷移金属*3や磁性体膜*4の高精度で超低損傷なエッチングに世界で初めて成功しました。
フラッシュメモリ、DRAMなど従来のメモリがメモリセル内の電子を用いて記録を行っているのに対し、MRAMは記憶媒体にハードディスクなどと同じ磁性体を用いたメモリ技術です。SRAM(高速アクセス性)、DRAM(高集積性)、フラッシュメモリ(不揮発性)等、各種メモリの備えるすべての強みを実現する「夢のメモリデバイス」として、省エネや瞬停にも寄与する汎用性の高いデバイスとして期待されています。しかし、MRAMデバイスにおける最も大きな問題の一つに、記憶媒体に使われる遷移金属や磁性体膜の加工の困難さがあります。遷移金属は揮発性に乏しく、物理的なエネルギーでスパッタリングする以外に加工できないため、微細化・高集積化が困難でした。そこで、東北大学の寒川教授グループは東京エレクトロン株式会社と共同で、寒川教授が独自に開発した中性粒子ビーム*5を用いた酸化・金属錯体反応による遷移金属、磁性体膜の化学反応エッチングを提案し、世界で初めてタンタル(Ta)、ルテニウム(Ru)、白金(Pt)等の遷移金属やNiFe磁性体膜を化学反応を用いて室温レベルで加工することに成功しました。中性粒子ビームによる酸化・金属錯体反応プロセスは基板への紫外線照射量や電荷蓄積量の抑制ができ、低温プロセスであることから、磁性体に対する損傷も同時に解決できるという大きな利点もあり、次世代のデバイスMRAMの微細化・高集積化に道を拓くプロセス技術として画期的な成果です。
本研究成果は、2014年6月9日-12日に開催される2014年VLSIテクノロジー回路シンポジウム(2014 International Symposium on Technology and Circuit)にてSession 6.5で谷勛(Xun Gu)博士から発表されます。
尚、本研究開発は、独立行政法人科学技術振興機構(JST)のJST復興促進センターで実施している復興促進プログラム(マッチング促進)における研究課題「次世代超低損傷微細加工プロセス用大口径中性粒子ビーム源の開発」において実施しています。今後、宮城県に生産体制をもつ東京エレクトロンから次世代デバイスMRAMの生産技術が実用化されれば、被災地での事業創出や雇用創出等の効果が期待されます。
フラッシュメモリ、DRAMなど従来のメモリがメモリセル内の電子を用いて記録を行っているのに対し、MRAMは記憶媒体にハードディスクなどと同じ磁性体を用いたメモリ技術です。原子数個程度の厚さの絶縁体薄膜を2層の磁性体薄膜で挟み、両側から加える磁化方向(磁石の磁力線の向き)を変化させることで抵抗値が変化する「TMR効果*6」を応用しています。MRAMは、アドレスアクセスタイムが10ns台、サイクルタイムが20ns台とDRAMの5倍程度でSRAM並み高速な読み書きが可能です。また、フラッシュメモリの10分の1程度の低消費電力、高集積性が可能などの長所があります。このため、SRAM や DRAM の置き換えになるのと同時に省エネや瞬停にも寄与する汎用性の高いデバイスとして期待されています。
しかし、そのMRAMデバイスにおける最も大きな問題の一つに、その記憶媒体に使われる遷移金属や磁性体膜の加工の困難さがあります。図1左に示すようにMRAMの作製にはタンタル(Ta)、ルテニウム(Ru)、白金(Pt)等の遷移金属を数nmの精度で重ねる必要がありますが、これらの物質は揮発性に乏しく、物理的なエネルギーでスパッタリングする以外に加工できないため、垂直な加工形状が得られず、側壁にエッチング生成物が堆積する現象がみられ(図1右)、デバイスの微細化・高集積化に限界があります。更に、揮発性を向上させるために高温でプラズマエッチング*7を行うことで磁性体の磁気特性が劣化するという課題も抱えています。
通常のプラズマエッチングプロセスは、既に半導体プロセスで用いられる多くの材料に対して適用されており、その反応メカニズムも明らかにされています。しかし、遷移金属および磁性体に関しては、プラズマエッチングプロセスで通常用いられるハロゲン系の反応メカニズムでは、エッチング処理後に残留ハロゲン化物による金属腐食が発生したり、反応生成物を蒸発させるため高い基板温度が必要であり、その熱履歴で磁気特性が劣化するなどのダメージが発生することが分かっています。
一方、アルゴンイオンの物理的スパッタリング現象を用いた加工方法(イオンミリング*8)は、マスクとの選択制が低く、エッチング側壁にスパッタリングされた原子が付着するために、そもそも微細化が難しいという問題があります。そこで、これらの問題を解決し、低温でしかも効率の良い化学反応を実現できる方法として、東北大学・寒川教授グループと東京エレクトロン株式会社は計算科学に基づいて従来の化学反応とは全く異なる酸化・金属錯体反応を提案しました。
今回のプロセスのキーポイントは、金属錯体反応を実現するために、遷移金属や磁性体に配位子を供給する前に表面を酸化させることにあります。通常、金属固体表面では密に充填された結晶構造をとるため、配位子がアクセスする空間的な広がりがなく、固体表面からの直接金属錯体反応は非常に起きづらいことが分かっています。
一方、酸化金属の結合長は、結晶の格子定数よりも大きく、また、密度が下がるため、配位子がアクセスできる空間的な余裕を持たせることが出来ると考えられます。但し、遷移金属や磁性体の酸化に通常の熱プロセスを用いると300-800℃の温度が必要であり、特にPtなどはそれでも酸化されないことが知られています。そこで、既に金属や半導体に照射することで、低温にて良質な酸化物を形成できることが実証されていた酸素中性粒子ビームによる酸化プロセスを用いて、金属錯体反応を進行させる配位子(エタノールなど)を同時に供給して、酸化および金属錯体反応を一貫して実現できる中性粒子ビームエッチング装置を開発しました(図2)。運動エネルギーを持った酸素中性粒子ビームは遷移金属および磁性体の表面を室温で効率よく酸化するとともに、金属酸化物表面にはプラズマを介さずに直接エタノールなどの配位子を供給して解離することなく吸着させることで酸化・金属錯体反応が進行します。この時、中性粒子ビームプロセスではUVや電子などの金属錯体反応を阻害するエネルギー粒子は完全に遮断されているため、酸素中性粒子ビームの運動エネルギーにより基盤温度が室温でも金属錯体反応が進行するという原理です。図3にTa, Ru, Ptなどの遷移金属の酸化・錯体反応によるエッチング形状を示します。通常酸化が難しいPtにおいても酸化・金属錯体反応が進行し、マスク通りに理想的な形状が実現できていることから、提案した中性粒子ビームによる酸化・金属錯体反応が実現できていることが実証されました。さらに、図4に示すように中性粒子ビームによる酸化・錯体反応エッチングにより加工された磁性体の磁気特性においてはプラズマエッチングで観測された磁気特性の劣化現象を完全に抑制できることも分かりました。
MRAMはSRAM(高速アクセス性)、DRAM(高集積性)、フラッシュメモリ(不揮発性)のすべての機能をカバーする「夢のメモリデバイス」として期待されています。しかし、現実にはまだ実用化に向けた加工技術がほとんど未開発です。具体的には、プラズマエッチングにおいて反応性加工を実現できる反応メカニズムが見つかっておらず、微細化が困難です。また、プラズマからの紫外線や電荷の照射や基板加熱により磁気特性を劣化させるなどの損傷の問題も実用化において大きな障害になっております。
我々は、実用的なプロセス技術の確立を目指して、2001年より中性粒子ビームの各種先端デバイスへの応用に関する検討及び技術開発の研究に着手してきました。今回はMRAMにおいて最も重要である遷移金属および磁性体の低温・化学反応エッチングへの中性粒子ビーム加工の適用と実際の加工特性および磁気特性の向上を実現し、世界で初めてMRAMの微細化・高集積化への展開が期待される新たな酸化・金属錯体反応を提案し、遷移金属および磁性体の超低損傷・低温反応性微細加工プロセスの有効性を明らかに示すことに成功しました。
中性粒子ビームによる加工・表面改質・材料堆積技術は、現在の半導体業界が直面している革新的ナノデバイスの開発を妨げるプロセス損傷を解決する全く新しいプロセス技術であると考えられます。また、本技術を用いた装置はプラズマプロセスとして実績がありもっとも安定した装置において用いられているプラズマ源をそのまま用い、中性化のためのグラファイトグリットを付加するだけで実現できる事から、今後、数十nm以下のMRAMデバイスにおける革新的なプロセスとして実用化されてゆく事もおおいに期待されるものです。中性粒子ビーム技術は既に均一大面積プロセスを実現できるプラズマ源を基盤に装置が実現できるため、極めて実用的であり、今後、最先端MRAM製造プロセスにおいて中性粒子ビーム加工技術のみならず、中性粒子ビームを用いた表面改質・修飾技術の研究開発を進めて実用的なデバイス開発を大いに推進していく予定です。
 図1.プラズマエッチングにおける磁性体・遷移金属のエッチング
図1.プラズマエッチングにおける磁性体・遷移金属のエッチング
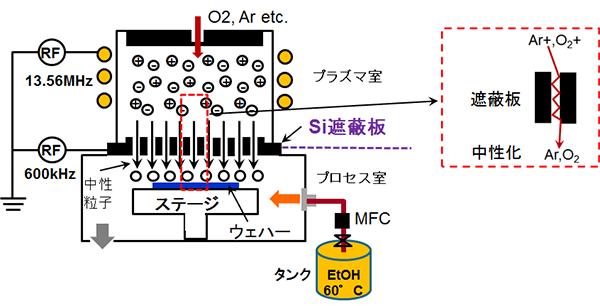 図2.中性粒子ビームによる酸化還元を用いた金属錯体反応エッチング装置概要図。
図2.中性粒子ビームによる酸化還元を用いた金属錯体反応エッチング装置概要図。
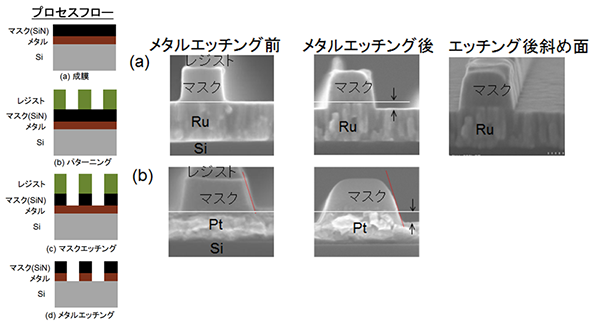 図3.遷移金属の金属錯体反応エッチング形状
図3.遷移金属の金属錯体反応エッチング形状
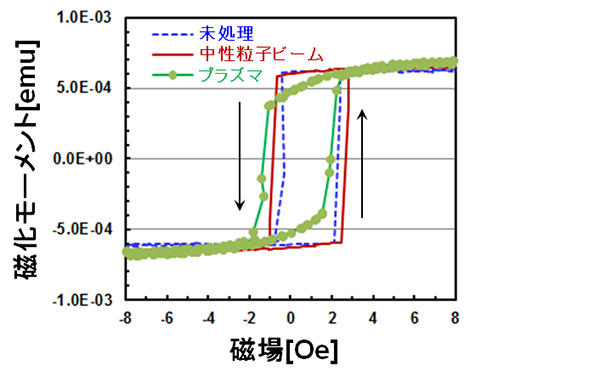 図4.中性粒子ビームによる酸化・錯体反応エッチングにおける磁性体ダメージ抑制効果
図4.中性粒子ビームによる酸化・錯体反応エッチングにおける磁性体ダメージ抑制効果
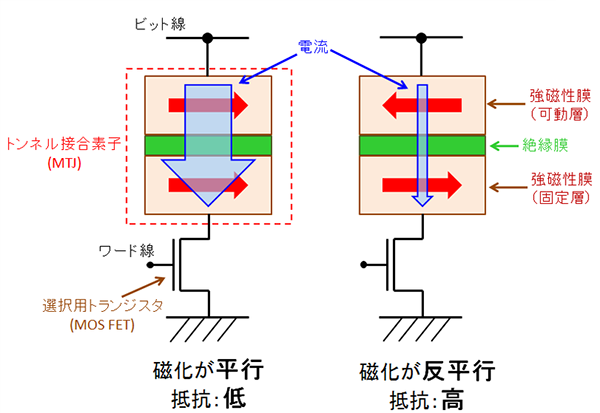
尚、今回の研究成果につきましては、6月9日から12日まで米国ハワイ州ホノルルで開催される2014年IEEE VLSIテクノロジー回路シンポジウム(2014 IEEE International Symposium on Technology and Circuit)においてSession 6.5で谷勛(Xun Gu)博士から報告を行う予定です。
| 論文題目: | A Novel Metallic Complex Reaction Etching for Transition Metal and Magnetic Material by Low-temperature and Damage-free Neutral Beam Process for Non-volatile MRAM Device Applications |
|---|
研究に関すること
寒川 誠二(サムカワ セイジ)
東北大学原子分子材料高等研究機構,
東北大学流体科学研究所未到エネルギー研究センターグリーンナノテクノロジー研究分野 教授
| 住所 : | 〒980-8577 仙台市青葉区片平2丁目1番1号 |
|---|---|
| TEL/FAX : | 022-217-5240 |
| E-MAIL : | samukawa@ifs.tohoku.ac.jp |
JST復興促進センターに関すること
櫻間 宣行(サクラマ ノリユキ)、松澤 義朗(マツザワ ヨシロウ)
科学技術振興機構 JST復興促進センター
| 住所 : | 〒980-0811 宮城県仙台市青葉区1番町4丁目6番1号 仙台第一生命タワービルディング20階 |
|---|---|
| TEL/FAX : | 022-395-5712 / 022-395-5830 |
| E-MAIL : | fukkou@jst.go.jp |
報道に関すること
中道康文(ナカミチ ヤスフミ)
東北大学原子分子材料科学高等研究機構(AIMR) 広報・アウトリーチオフィス
| TEL : | 022-217-6146 |
|---|---|
| E-MAIL : | outreach@wpi-aimr.tohoku.ac.jp |
独立行政法人 科学技術振興機構(JST)広報課
| TEL/FAX : | 03-5214-8404 / 03-5214-8432 |
|---|---|
| E-mail : | jstkoho@jst.go.jp |